

随着半导体器件的体积越来越小、速度越来越快、工作功率越来越高,不可避免地会产生热量。当热量超过一定临界值时,集成电路设备的性能和效率就会显著下降。高效传热是热解决方案设计中必须考虑的一个重要方面。要了解设计中的最佳匹配和组合,需要考虑三个关键方面:
集成电路装置
● 设备的最大功率是多少?
● 集成电路设备的实际发热量。
让我举个简单的例子,即使设备的最大功率可能是 200W,但这并不是一个常数,它会根据实际使用水平而变化。使用高级游戏或人工智能模拟可能会占用更多的电力资源,从而导致温度升高,但使用标准 Excel、Words 等则会占用很低的电力资源。
冷却系统
● 冷却系统可以是传统的散热器、热管、水或制冷剂冷却器。
冷却系统的选择取决于需要达到的温度、冷却速度和安装空间。重要的是要有足够的冷却量来去除热量。
热界面材料(TIM)
● 热界面材料有多种类型,包括导热膏、导热垫、石墨片、相变材料或液态金属。
选择取决于成本、表面翘曲、应用压力、预期性能等因素。
半导体器件的热传递可分为三个不同的部分:
从集成电路封装到冷却介质的热传导
● 冷却介质有多种选择
○ 直接连接到产品外壳/机箱
○ 散热器/风扇
○ 热管/风扇
○ 液体冷却
○ 制冷剂冷却
TIM的选择取决于运行条件和安装的机械限制

冷却介质向环境的热传递
环境温度会影响传热效率的结果。
在半导体器件中,集成电路封装分为有盖和无盖两类。在最终的现场安装和生产测试中,这两种配置会有不同的TIM堆叠。
无盖封装
对于无盖封装,芯片将通过倒装芯片工艺直接安装到器件封装上。由于空间限制,封装通常会直接安装在 PCB 板上,因为它将用于笔记本电脑或移动设备。安装后,芯片将直接散热到冷却介质中。至于带盖封装,则会在封装上的裸片外加一个金属盖。在这种情况下,需要在芯片顶部和金属盖之间设置一个 散热片,以确保热量能够传出。
在无盖封装的热传递过程中,安装散热片时必须小心谨慎,因为模具很脆,在受到直接冲击力或高压压缩时可能会损坏。另一个可能的问题是散热片会造成无源元件短路。由于芯片较小,冷却器的冷却能力应适当提高,因为热量是通过较小的表面积散失的。可以考虑的方案之一是使用热解石墨,这种石墨是用高取向石墨聚合物薄膜合成的,具有很高的面内热导率(可超过 1900W/m-K)。
如果是笔记本电脑或移动设备,热量将从设备传递到外壳,以便均匀散热。
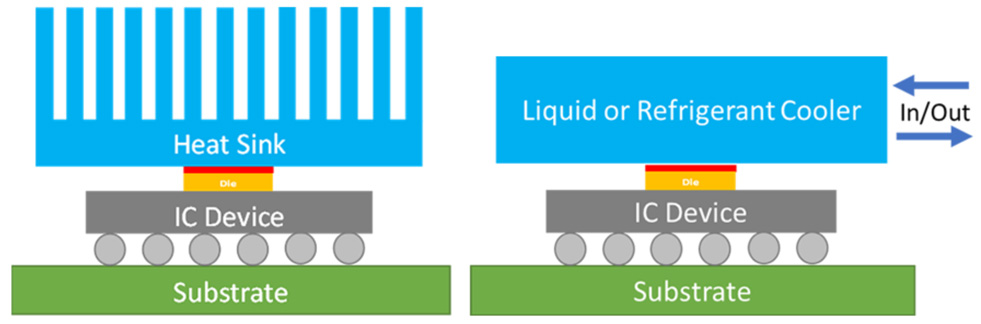
带盖封装
对于带盖封装,芯片将通过倒装芯片工艺直接安装到器件封装上,然后在印刷电路板基板上密封一个金属盖,以覆盖和保护芯片。封装通常安装在 PCB 板上的插座上。这种封装通常用于台式机和服务器产品。

在这种设置中,模具和金属盖之间需要有一个 散热片,以确保模具的热量能有效地传递出去。金属盖顶部与冷却介质之间也需要一个散热片。
冷却介质的形式可以是散热片/风扇、热管/风扇、液体冷却或冷冻冷却。游戏玩家通常使用液体冷却 CPU 来提高游戏速度和性能。
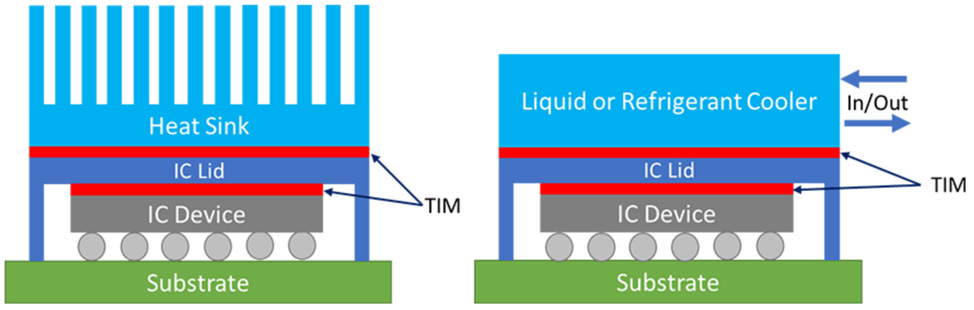
在工厂进行生产测试时,所有 CPU/GPU 都将进行 100% 的系统级测试,以模拟真实环境中软件在高温下的使用情况。冷却器/加热器的配置将具有额外的功能和能力,以精确控制温度,并对温度和功率变化具有高响应灵敏度。
散热解决方案的选择取决于集成电路设备的预期性能、可用空间和预算。
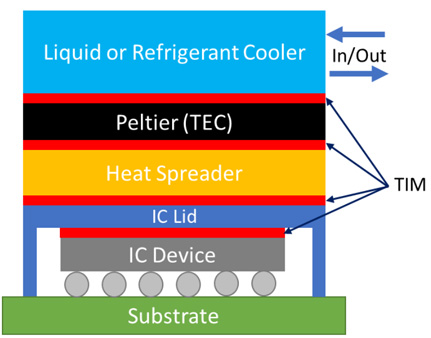

Inspiraz Technology Pte Ltd
 Blk 21, Kallang Avenue, #06-173 S339412
Blk 21, Kallang Avenue, #06-173 S339412
 +65 6297 0880
+65 6297 0880
 sales@inspiraz.com
sales@inspiraz.com
凭借30多年的热管理经验,我们为国际客户提供切实可行的热问题解决方案。我们为半导体、消费电子、汽车、LED、电信、医疗设备、电池等不同市场提供热界面材料(TIM)。
●热界面材料(TIM)用于两个表面之间的热传递(从较高的热能到较低的热能)。
● 此类材料通常用于增强功率半导体和器件的热传导。
● 目前的散热片技术包括导热脂/膏、相变材料、焊膏和导热胶带。
● 随着技术的不断进步,人们对半导体和电子设备的性能有了更高的要求,从而将产生更高的热量,因此需要更好、更高效的散热材料。
搬运和储存指南网站链接
热管理KML隐私政策